На конференции IEEE ECTC 2025 компания Intel анонсировала EMIB-T — усовершенствованную версию технологии межкристальных соединений с поддержкой высокоскоростной памяти HBM4 и интерфейса UCIe. Новая технология сочетает элементы 2.5D и 3D-упаковки для создания более эффективных многокристальных решений.
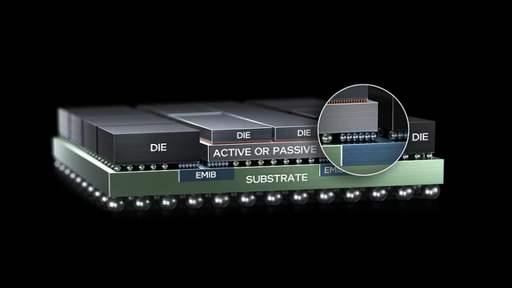
G. Ostrov
Компания Intel продолжает развивать свои технологии упаковки полупроводников, представив на конференции IEEE ECTC 2025 в Далласе новую технологию EMIB-T (Embedded Multi-die Interconnect Bridge с TSV). Это решение представляет собой значительный шаг вперёд в области многокристальной интеграции.
Ключевые особенности EMIB-T
EMIB-T является развитием существующей технологии EMIB, в которую добавлены сквозные кремниевые переходы (TSV). Основные преимущества новой технологии:
- Поддержка высокоскоростной памяти HBM4 и HBM4e
- Совместимость с интерфейсом UCIe-A с пропускной способностью до 32 Гбит/с
- Улучшенная подача питания через нижнюю часть упаковки
- Снижение сопротивления и устранение проблем падения напряжения
- Сочетание элементов 2.5D и 3D-упаковки
Технические характеристики и масштабируемость
Новая технология позволяет создавать впечатляющие по размерам упаковки:
- Максимальный размер упаковки: до 120 × 180 мм
- Поддержка более 38 мостов в одной упаковке
- Интеграция более 12 кристаллов
- Уменьшенный шаг соединений: с 55 до 45 микрон
- Перспектива дальнейшего снижения до 35 и 25 микрон
EMIB-T совместима как с органическими, так и со стеклянными подложками, что открывает новые возможности для масштабирования и повышения плотности интеграции.
Дополнительные инновации
Помимо основной технологии EMIB-T, Intel представила ряд сопутствующих решений:
Усовершенствованный тепловой распределитель
Новая конструкция теплового распределителя разделена на плоскую пластину и усиливающий элемент. Это нововведение:
- Улучшает контакт с теплопроводящим материалом
- Снижает вероятность образования пустот на 25%
- Повышает общую эффективность теплоотвода
Технология термокомпрессионного соединения
Новая технология соединения повышает надёжность и выход годных изделий при производстве крупных упаковок, что критически важно для массового производства.
Партнёрства и экосистема
Intel активно развивает экосистему поддержки EMIB-T, сотрудничая с ведущими компаниями:
- EDA-разработчики: Cadence, Siemens, Synopsys
- Измерительное оборудование: Keysight для поддержки проектирования чиплетов
- Стандарты: UCIe 2.0 и BoW (Bunch of Wires)
Применение и перспективы
EMIB-T становится ключевым элементом стратегии Intel по объединению различных компонентов в одном корпусе. Технология особенно актуальна для:
- Решений искусственного интеллекта
- Центров обработки данных
- Высокопроизводительных вычислений
- Интеграции компонентов от разных производителей
Новая технология открывает возможности для более гибкой интеграции компонентов от разных производителей, что соответствует тенденциям развития открытых стандартов в полупроводниковой отрасли.
Подробную техническую информацию можно найти на официальном сайте Intel Foundry.
В случае каких-либо проблем напишите нам, мы поможем быстро и качественно!




