At the IEEE ECTC 2025 conference, Intel announced EMIB-T — an advanced version of its inter-die connection technology supporting high-speed HBM4 memory and UCIe interface. The new technology combines 2.5D and 3D packaging elements to create more efficient multi-die solutions.
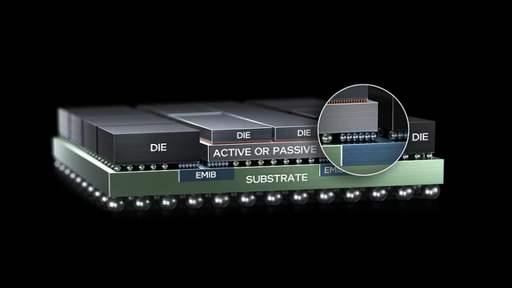
G. Ostrov
Intel continues to advance its semiconductor packaging technologies by introducing EMIB-T (Embedded Multi-die Interconnect Bridge with TSV) at the IEEE ECTC 2025 conference in Dallas. This solution represents a significant step forward in multi-die integration technology.
Key Features of EMIB-T
EMIB-T is an evolution of the existing EMIB technology with added through-silicon vias (TSV). The main advantages of the new technology include:
- Support for high-speed HBM4 and HBM4e memory
- Compatibility with UCIe-A interface up to 32 Gbps bandwidth
- Improved power delivery through the bottom of the package
- Reduced resistance and elimination of voltage drop issues
- Combination of 2.5D and 3D packaging elements
Technical Specifications and Scalability
The new technology enables creation of impressively sized packages:
- Maximum package size: up to 120 × 180 mm
- Support for more than 38 bridges in a single package
- Integration of more than 12 dies
- Reduced connection pitch: from 55 to 45 microns
- Roadmap for further reduction to 35 and 25 microns
EMIB-T is compatible with both organic and glass substrates, opening new possibilities for scaling and increasing integration density.
Additional Innovations
Besides the core EMIB-T technology, Intel presented several complementary solutions:
Advanced Thermal Spreader
The new thermal spreader design is split into a flat plate and reinforcing element. This innovation:
- Improves contact with thermal interface material
- Reduces void formation probability by 25%
- Enhances overall thermal dissipation efficiency
Thermocompression Bonding Technology
The new bonding technology increases reliability and yield for large package manufacturing, which is critical for mass production.
Partnerships and Ecosystem
Intel is actively developing the EMIB-T support ecosystem, collaborating with leading companies:
- EDA developers: Cadence, Siemens, Synopsys
- Test equipment: Keysight for chiplet design support
- Standards: UCIe 2.0 and BoW (Bunch of Wires)
Applications and Prospects
EMIB-T becomes a key element of Intel's strategy for combining various components in a single package. The technology is particularly relevant for:
- Artificial intelligence solutions
- Data center applications
- High-performance computing
- Integration of components from different manufacturers
The new technology opens possibilities for more flexible integration of components from different manufacturers, aligning with the trend toward open standards in the semiconductor industry.
Detailed technical information can be found on the official Intel Foundry website.
If you have any problems, contact us, we will help quickly and efficiently!




